Dispersão de transportadora - Carrier scattering
Os tipos de defeito incluem vazios de átomos, adátomos , etapas e dobras que ocorrem com mais frequência em superfícies devido ao tamanho finito do material que causa a descontinuidade do cristal. O que todos os tipos de defeitos têm em comum, sejam defeitos superficiais ou volumosos, é que eles produzem ligações pendentes que têm níveis específicos de energia de elétrons diferentes daqueles da massa. Essa diferença ocorre porque esses estados não podem ser descritos com ondas Bloch periódicas devido à mudança na energia potencial do elétron causada pela falta de núcleos de íons fora da superfície. Conseqüentemente, esses são estados localizados que requerem soluções separadas para a equação de Schrödinger para que as energias dos elétrons possam ser descritas adequadamente. A quebra na periodicidade resulta em uma diminuição na condutividade devido ao espalhamento do defeito .
Níveis de energia eletrônica de ligações pendentes de semicondutores

Uma maneira mais simples e qualitativa de determinar os níveis de energia das ligações pendentes é com os diagramas de Harrison. Os metais têm ligação não direcional e um pequeno comprimento de Debye que, devido à sua natureza carregada, torna as ligações pendentes irrelevantes, se é que podem mesmo ser consideradas existentes. Semicondutores são dielétricos, então os elétrons podem sentir e ficar presos em estados de energia defeituosos. Os níveis de energia desses estados são determinados pelos átomos que constituem o sólido. A Figura 1 mostra o diagrama de Harisson para o semicondutor elementar Si. Da esquerda para a direita, a hibridização orbital s e orbital p promove a ligação sp 3 que, quando vários dímeros sp 3 Si-Si são combinados para formar um sólido, define as bandas de condução e valência. Se uma vacância existisse, como aquelas em cada átomo na interface sólido / vácuo, isso resultaria em pelo menos uma ligação sp 3 quebrada que tem uma energia igual à de átomos de Si auto-hibridizados simples, como mostrado na Figura 1 Esta energia corresponde aproximadamente ao meio do bandgap de Si, ~ 0,55eV acima da banda de valência. Certamente este é o caso mais ideal, ao passo que a situação seria diferente se a passivação da ligação (veja abaixo) e a reconstrução da superfície , por exemplo, ocorressem. Experimentalmente, as energias desses estados podem ser determinadas usando espectroscopia de absorção ou espectroscopia de fotoelétrons de raios-X , por exemplo, se a sensibilidade do instrumento e / ou densidade de defeito forem altas o suficiente.

Semicondutores compostos, como GaAs, têm estados de ligação pendentes que estão mais próximos das bordas da banda (consulte a Figura 2). À medida que a ligação se torna cada vez mais iônica, esses estados podem até agir como dopantes . Esta é a causa da conhecida dificuldade de dopagem com GaN p-tipo, onde N vacâncias são abundantes devido à sua alta pressão de vapor resultando em alta densidade de ligação oscilante de Ga. Esses estados estão próximos à borda da banda de condução e, portanto, atuam como doadores. Quando dopantes aceitadores do tipo p são introduzidos, eles são imediatamente compensados pelas N vagas. Com esses estados rasos, seu tratamento é frequentemente considerado como um análogo ao átomo de hidrogênio como segue para o caso de lacunas de ânion ou cátion (massa efetiva do buraco, m *, para cátion e elétron m * para vacâncias de ânion). A energia de ligação, E c -E db , é
onde U = -q 2 / (4πεε r r) é o potencial eletrostático entre um elétron que ocupa a ligação pendente e seu núcleo de íon com ε, a constante de permissividade do espaço livre, ε r , a permissividade relativa e r a separação do núcleo elétron-íon. A simplificação de que a energia translacional do elétron, KE = -U / 2, se deve ao teorema virial para potenciais centrosimétricos. Conforme descrito pelo modelo de Bohr , r está sujeito a quantização .
O momento do elétron é p = mv = h / λ tal que
resultando em
e . Este tratamento perde precisão à medida que os defeitos tendem a se afastar de qualquer borda da banda.
Espalhamento de defeito
Os níveis de energia da ligação oscilante são autovalores das funções de onda que descrevem os elétrons nas proximidades dos defeitos. Na consideração típica de espalhamento de portadora, isso corresponde ao estado final da regra de ouro de frequência de espalhamento de Fermi :
com H 'sendo o parâmetro de interação e a função delta de Dirac , δ (E f -E i ), indicando espalhamento elástico . A relação simples 1 / τ = Σ k ', k S k'k torna esta uma equação útil para caracterizar propriedades de transporte de material quando usado em conjunto com σ = ne 2 τ / m * e a regra de Matthiessen para incorporar outros processos de espalhamento.
O valor de S k'k é determinado principalmente pelo parâmetro de interação, H '. Este termo é diferente dependendo se os estados rasos ou profundos são considerados. Para estados rasos, H 'é o termo de perturbação do hamiltoniano redefinido H = H o + H', com H o tendo uma energia de autovalor de E i . A matriz para este caso é
onde k 'é o vetor de onda do estado final do qual há apenas um valor, uma vez que a densidade do defeito é pequena o suficiente para não formar bandas (~ <10 10 / cm 2 ). Usando a equação de Poisson para Fourier cargas pontuais periódica, ,
dá o coeficiente de Fourier do potencial a partir de uma ligação de oscilação V q = E / (q 2 εε r V), onde V é o volume. Isso resulta em
onde q s é a correção do vetor de onda do comprimento de Debye devido à blindagem de carga. Então, a frequência de espalhamento é onde n é a densidade volumétrica do defeito. Realizando a integração, utilizando | k | = | k '|, dá .
O tratamento acima vacila quando os defeitos não são periódicos, pois os potenciais de ligação pendentes são representados com uma série de Fourier. Simplificar a soma pelo fator de n na Eq (10) só foi possível devido à baixa densidade de defeitos. Se cada átomo (ou possivelmente qualquer outro) tivesse uma ligação pendente, o que é bastante razoável para uma superfície não reconstruída, a integral em k 'também deve ser realizada. Devido ao uso da teoria de perturbação na definição da matriz de interação, o acima assume pequenos valores de H 'ou, estados de defeitos rasos próximos às bordas da banda. Felizmente, a regra de ouro de Fermi em si é bastante geral e pode ser usada para defeitos de estado profundo se a interação entre o elétron de condução e o defeito for bem compreendida para modelar sua interação em um operador que substitua H '.
Medidas experimentais

A determinação da extensão que essas ligações pendentes têm no transporte elétrico pode ser observada experimentalmente com bastante rapidez. Ao varrer a tensão através de um condutor (Figura 3), a resistência e com uma geometria definida, a condutividade da amostra pode ser determinada. Como mencionado antes, σ = ne 2 τ / m *, onde τ pode ser determinado sabendo n e m * da posição do nível de Fermi e da estrutura da banda do material. Infelizmente, este valor contém efeitos de outros mecanismos de dispersão, como devido a fônons. Isso ganha utilidade quando a medição é usada ao lado da Eq (11), onde a inclinação de um gráfico de 1 / τ versus n torna E c -E db calculável e a interceptação determina 1 / τ de todos, exceto processos de espalhamento de defeito. Isso requer a suposição de que o espalhamento de fônons (entre outros processos possivelmente desprezíveis) é independente da concentração de defeitos.
Em um experimento semelhante, pode-se apenas abaixar a temperatura do condutor (Figura 3) para que a densidade do fônon diminua para desprezível, permitindo a resistividade dominante do defeito. Com este caso, σ = ne 2 τ / m * pode ser usado para calcular diretamente τ para espalhamento de defeito.
Passivação

Os defeitos de superfície sempre podem ser "passivados" com átomos para ocupar propositalmente os níveis de energia correspondentes, de modo que os elétrons de condução não possam se espalhar para esses estados (efetivamente diminuindo n na Eq (10)). Por exemplo, a passivação de Si na interface canal / óxido de um MOSFET com hidrogênio (Figura 4) é um procedimento típico para ajudar a reduzir a densidade de defeito de ~ 10 10 cm -2 em até um fator de 12, melhorando assim a mobilidade e, portanto, velocidades de comutação. A remoção de estados intermediários que de outra forma reduziriam as barreiras de tunelamento também diminui a corrente de fuga da porta e aumenta a capacitância da porta , bem como a resposta transiente. O efeito é que a ligação Si sp 3 fica totalmente satisfeita. A exigência óbvia aqui é a capacidade para o semicondutor para oxidar o átomo de passivação ou, E c -E db + χ> E eu , com o semicondutor de electrões afinidade χ e átomo de energia de ionização E eu .
Dispersão de fonemas
Agora consideramos o espalhamento de portadoras com deformações de rede denominadas fônons . Considere o deslocamento volumétrico que essa onda de propagação produz, o que consequentemente resulta em uma deformação dependente do tempo, onde uma onda plana simples é usada para descrever a propagação do fônon ,. Deslocamento de átomos de distância a partir de suas posições de equilíbrio, geralmente faz com que uma mudança na estrutura de banda electrónico (Figura 5), onde, para a dispersão, nós estamos preocupados com os electrões da banda de condução de energia E ~ CB , . O parâmetro empírico, Z DP , é denominado potencial de deformação e descreve a força de acoplamento elétron-fônon. Multiplicando pela população de fônons ( distribuição de Bose-Einstein , N q ) dá o potencial de deformação total,
(a razão para a raiz será aparente abaixo). Aqui, o + corresponde à emissão de fônons e - à absorção de fônons durante o evento de espalhamento. Uma nota, porque para fônons transversais, apenas as interações com fônons longitudinais são diferentes de zero. Portanto, a matriz de interação completa é onde o delta de Kronecker impõe a conservação do momento e surge da suposição de que as funções de onda eletrônicas (estado final , e estado inicial, ) são ondas planas também.
Fônons acústicos
Usando a regra de ouro de Fermi, a taxa de espalhamento para fônons acústicos de baixa energia pode ser aproximada. A matriz de interação para esses fônons é com a freqüência radial do fônon ω q = cq, o volume V, a densidade do sólido ρ e a velocidade do grupo de fônons c. Conectando isso à Eq. 6 dá . Com as premissas de que N q >> 1, ħω << kT e g (E ') ~ g (E) (o que geralmente é válido para cristais 3D, uma vez que as energias elétricas de condução são geralmente muito maiores do que ħω e g (E) não tem qualquer van Hove (singularidade ) fornece a taxa de espalhamento: onde g (E) é a densidade eletrônica de estados para os quais a solução tridimensional com dispersão parabólica foi usada para obter a resposta final.
Fônons óticos
Normalmente, os fônons nos ramos ópticos das relações de dispersão vibracional têm energias da ordem de ou maiores que kT e, portanto, as aproximações ħω << kT e N q >> 1 não podem ser feitas. Ainda assim, uma rota razoável que ainda fornece um desvio de lidar com dispersões de fônons complexas é usar o modelo de Einstein, que afirma que apenas um modo de fônon existe nos sólidos. Para fônons ópticos, essa aproximação acaba sendo suficiente devido a muito pouca variação de inclinação em ω (q) e, portanto, podemos reivindicar ħω (q) ≅ ħω, uma constante. Consequentemente, N q também é uma constante (apenas T dependente). A última aproximação, g (E ') = g (E ± ħω) ~ g (E), não pode ser feita uma vez que ħω ~ E e não há solução alternativa para isso, mas a complexidade adicionada à soma de τ é mínima.
.
A soma muda para a densidade de estados em E 'e a distribuição de Bose-Einstein pode ser retirada da soma devido a ħω (q) ≅ ħω.
Notas
- ^ Harrison, Walter A., Estrutura eletrônica e as propriedades dos sólidos: A física da ligação química. São Francisco: Freeman, 1980.
- ^ Rockett, Angus, a ciência de materiais dos semicondutores. Nova York: Springer, 2007
- ^ Hess, Karl, Teoria Avançada de Dispositivos Semicondutores. Nova York: Wiley Interscience, 2000.
- ^ Faughnan, B .; Ipri, AC IEEE Trans. Elec. Dev. 36 , 101, 1999.
- ^ Conwell, EM, "High Field Transport in Semiconductors", em Solid State Physics, ed. F. Seitz, D. Turnbull e H. Ehrenreich, Suplemento 9. Nova York: Academic Press, 1967, p. 108










![{\ displaystyle {\ frac {1} {\ tau}} = \ sum _ {{\ bar {k}} ', {\ bar {k}}} S _ {{\ bar {k}}' {\ bar { k}}} = n \ sum _ {\ bar {k}} {\ frac {2 \ pi} {\ hbar}} {\ frac {e ^ {4} \ delta (E _ {\ bar {k}} - E _ {{\ bar {k}} '})} {\ varepsilon \ varepsilon _ {r} V [{\ bar {q}} ^ {2} -q_ {s} ^ {2}] ^ {2}} } = {\ frac {ne ^ {4}} {4 \ pi ^ {2} \ hbar \ varepsilon \ varepsilon _ {r}}} \ int \ int \ int dkd \ theta d \ phi {\ frac {k ^ {2} sin \ theta \; \ delta (E _ {\ bar {k}} - E _ {{\ bar {k}} '})} {[{\ bar {q}} ^ {2} -q_ {s } ^ {2}] ^ {2}}} \; \; (10)}](https://wikimedia.org/api/rest_v1/media/math/render/svg/563dab99ccb2f8c08a1a5c2bad1979bd49e7d73b)






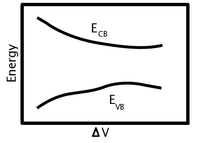





![{\ displaystyle S_ {k'k} ^ {Ac} = {\ frac {2 \ pi} {\ hbar}} Z_ {DP} ^ {2} {\ frac {\ hbar \ omega _ {q}} {2V \ rho c ^ {2}}} (N_ {q} + {\ frac {1} {2}} \ pm {\ frac {1} {2}}) \ delta _ {k ', k \ pm q} \ delta [E (k ') - E (k) \ pm \ hbar \ omega _ {q}] \; \; (16)}](https://wikimedia.org/api/rest_v1/media/math/render/svg/ce4409fbb8cc02f676524c512a2c035e41876d2d)

![{\ displaystyle = {\ frac {2 \ pi} {\ hbar}} Z_ {DP} ^ {2} {\ frac {\ hbar \ omega _ {q}} {2V \ rho c ^ {2}}} ( {\ frac {kT} {\ hbar \ omega _ {q}}}) \ sum _ {k} \ delta _ {k ', k \ pm q} \ delta [E (k') - E (k) \ pm \ hbar \ omega _ {q}]}](https://wikimedia.org/api/rest_v1/media/math/render/svg/a16459c2d31e39a0458f4751ba9ea65e25d1f6d9)


![{\ displaystyle {\ frac {1} {\ tau}} = \ sum _ {k '} S_ {k'k} ^ {Op} = {\ frac {2 \ pi} {\ hbar}} Z_ {DP} ^ {2} {\ frac {\ hbar \ omega} {2V \ rho c ^ {2}}} (N_ {q} + {\ frac {1} {2}} \ pm {\ frac {1} {2 }}) \ sum _ {k '} \ delta _ {k', k \ pm q} \ delta [E (k ') - E (k) \ pm \ hbar \ omega]}](https://wikimedia.org/api/rest_v1/media/math/render/svg/2d40d6e190162c4856c40348d1e46e9ab5c4bf39)
